BGA返修及焊接工艺
多数半导体器件的耐热温度为240℃――300℃,对于BGA返修系统来说,加热温度和均匀性的控制显得非常重要。BGA芯片焊接工艺步骤如下:

1、电路板、BGA预热:
电路板、芯片预热的主要目的是将潮气去除以免PCB起泡和芯片爆,如果电路板和BGA内的潮气很小(如芯片刚拆封),这一步可以免除。
2、拆除BGA:
拆除的BGA如果不打算重新使用,而且PCB可承受高温,拆除BGA可采用较高的温度(较短的加热周期),主板上BGA取下来后,至少要等一分钟才能把BGA从返修台上拿下来,不然PCB板会变形。
3、 清洁焊盘:
清洁焊盘主要是将拆除BGA芯片后留在PCB表面的焊
锡膏清理掉,必须使用符合要求的清洗剂。为了保证BGA焊料可靠性,一般不能使用焊盘上的残留
助焊膏,必须将旧的助焊膏清除掉,除非BGA上重新形成BGA焊料球。由于BGA体积小,特别是CSP(或μBGA体积更小,清洁焊盘比较困难,所以在返修CSP时,如果CSP的周围空间很小,就需使用
免清洗助焊膏,为保让返修的BGA的焊接可靠性,PCB上的BGA焊接位置必须尽可能的平。
4、 涂助焊膏:
这准备好的PCB板上涂上助焊膏,这个工序要特别注意,涂均匀。
在PCB上涂助焊膏对于BGA的返修结果有重要影响。通过选取用与BGA相符的模板,可很方便地将助焊膏涂在电路板上。对于CSP,有3种焊膏可以先选:普通型助焊膏,免清洗助焊膏和水溶性助焊膏。使用普通型助焊膏,回流时间可略长些,使用免清洗助焊膏,回流温度应选的低些。

(1)贴装:贴装的主要目的是使BGA上的每个焊料与PCB上的焊盘对准。必须使用专门的设备来对中。
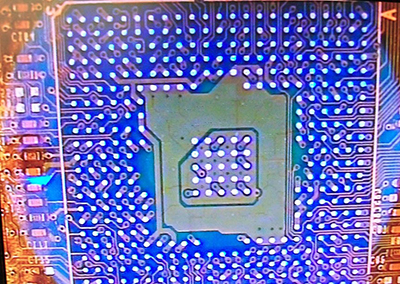
(2)热风回流焊:热风回流焊是整个返修工艺的关键。
A、 BGA返修回流焊的曲线应当与BGA的原始焊接曲线接近,热风回流焊曲线分成六个区间:预热区、保温、升温、焊接1、焊接2和冷却区,六个区间的温度、时间参数可以分别设定,通过计算机连接,可以将这些程序存储和随时调用。
B、 在回流焊接过程中要正确选择各区的加热温度和时间,同时应注意升温的速度。一般,在100℃以前,最大的升温速度不超过10℃/s,100℃以后最大温速 度不超过5℃/s,在冷却区,最大的冷却速度不超过6℃/s,因为过高的升温速度和降温速度都可能损坏PCB和BGA,这种损坏有时是肉眼不能观察到的。 不同的BGA,不同的助焊膏,应选择不同的加热温度和时间。如CBGA BGA的同流温度应高于PBGA的回流温度,90pb/10Sn,应该63 Sn/37 pb助焊膏选用更高的回流温度。对免洗助焊膏,其活性低于非免洗助焊膏,因此,焊接温度不宜过高,焊接时间不宜过 长,以防止焊料颗粒的氧化。
C、 热风回流焊中,PCB板的底部必须能够加热。这种加热的目的有二个:避免由于PCB板的单面受热而产生翘曲和变形;使助焊膏熔化的时间缩短。对于尺寸板的 BGA返修,这种底部加热尤其重要。BGA返修设备的底部加热方式有两种,一种是热风加热,一种是红外加热。热风加热的优点是加热均匀,一般返修工艺建议 采用这种加热。红外加热的缺点是PCB受热不均匀。
D、要选择好的热风回流吸嘴。热风回流喷嘴属于非接触式加热,加热时依靠高温空气对流使BGA上的各焊点的焊料同时熔化。保证在整个回流过程中有稳定的温度环境,同时可保护相邻件不被对流热空气回热损坏。